PHI 710 扫描俄歇纳米探针
简介
PHI 710扫描俄歇纳米探针是一台设计独特的高性能的俄歇电子能谱(AES)仪器。该设备能分析纳米级特征区域,超薄薄膜和多层结构材料表界面的元素态和化学态信息。作为高空间分辨率,高灵敏度和高能量分辨率的俄歇电子能谱仪, PHI 710可以为用户提供纳米尺度方面的各种分析需求。

PHI 710 扫描俄歇纳米探针
特点
SEM分辨率≤ 3 nm, AES分辨率≤ 8 nm
在俄歇能谱的采集分析过程中,包括谱图,深度剖析及元素分布成像,首先需要在SEM图像上定义样品分析区域,同时要求束斑直径小且稳定。PHI 710 SEM图像的空间分辨率小于3 nm,AES的空间分辨率小于8 nm(@ 20 kV, 1 nA),如下图所示。

图1 Si基底上的Au的SEM图像,PHI 710 SEM图像的空间分辨率小于3 nm
图2铸铁韧性断裂的界面分析,左边是SEM图像,中间是钙,镁,钛的俄歇成像谱图叠加,右边则是硫的俄歇成像,这充分证明了PHI 710在纳米级的尺度下的化学态的分析能力。
同轴筒镜分析器(CMA)
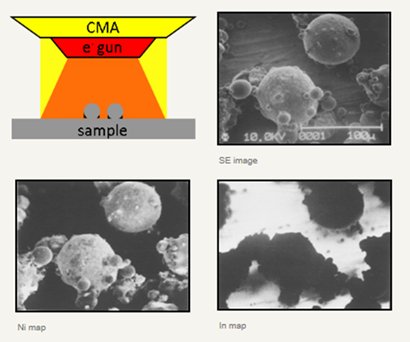

PHI 公司电子枪和同轴筒镜分析器同轴的几何设计,具有灵敏度高和各个角度均可收集信号的特点,满足了表面粗糙不平整样品对俄歇分析全面表征能力的需求。如上图所示,所有俄歇的数据都是从颗粒的各个方向收集而来,成像没有阴影。若设备配备的不是同轴分析器,则仪器的灵敏度会降低,并且成像有阴影,一些分析区域会由于位置的原因,而无法分析。如果想要得到高灵敏度,只能分析正对着分析器的区域。如下图所示,若需要对颗粒的背面,颗粒与颗粒之间的区域分析,图像会有阴影。

俄歇能谱仪的化学态成像
图谱成像
PHI 710能从俄歇成像分析的每个像素点中提取出谱图的相关信息,该功能可以实现化学态成像。
高能量分辨率俄歇成分像
下图是半导体芯片测试分析,测试的元素是Si。通过对Si的俄歇影像进行线性最小二乘法拟合(LLS),俄歇谱图很清楚的反映出了三个Si的不同化学态的区域,分别是:单质硅,氮氧化硅和金属硅,并且可以从中分别提取出对应的Si的俄歇谱图,如最下方三张图所示。

纳米级的薄膜分析
如下图SEM图像中所示,以硅为衬底的镍的薄膜上有缺陷,这是由于退火后,在界面处形成了硅镍化合物。分别在缺陷区域和正常区域设置了一个分析点,分析条件为高能量分辨率模式下(0.1%),电子束直径20 nm,离子枪采用0.5 kV设定,如下图所示,在MultiPak软件中,采取最小二乘拟合法用于区分金属镍和硅镍化合物,同样区分金属硅和硅化物。可以看出,硅镍化合物仅存在于界面处,而在镍薄膜层和硅衬底中都不存在。但是,在镍涂层的缺陷处,发现了硅镍化合物。
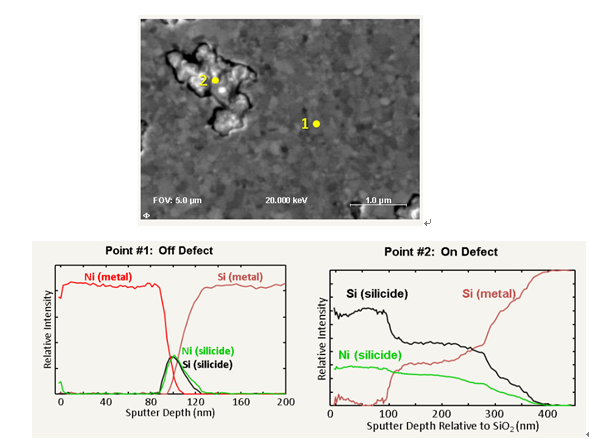
PHI SmartSoft-AES用户界面
PHI SmartSoft是一个方便使用的仪器操作软件。软件通过任务导向和卷标横跨顶部的显示指导用户输入样品,定义分析点,并设定分析。一个强大的“自动Z轴定位”功能可定义多个分析点并达到最理想的样品分析定位。简洁明了的界面设计以及软件功能设置能够让操作者快速上手,方便设置,保存和调取分析参数。

PHI MultiPak 数据处理软件
MultiPak软件拥有最全面的俄歇能谱数据库。采谱分析,线扫描分析,成像和深度剖析的数据都能用MultiPak来处理。它强大的功能包括峰的定位,化学态信息及检测限的提取,定量测试和图像的增强等。

选配件
- 真空室内原位样品放置台
- 原位断裂
- 真空传送管
- 预抽室导航相机
- 电子能量色散探测器(EDS)
- 电子背散射衍射探测器(EBSD)
- 背散射电子探测器(BSE)
- 聚焦离子束(FIB)
应用领域
- 半导体组件: 缺陷分析、刻蚀/清洁残余物分析、短路问题分析、接触污染物分析、接口扩散现象分析、封装问题分析等、FIB组件分析
- 显示器组件: 缺陷分析、刻蚀/清洁残余物分析、短路问题分析、接触污染物分析、接口扩散现象分析等
- 磁性储存组件: 定义层、表面元素、接口扩散分析、孔洞缺陷分析、表面污染物分析、磁头缺陷分析、残余物分析等
- 玻璃及陶瓷材料: 表面沉积物分析、清洁污染物分析、晶界分析等
立即与高德的营销与服务队伍联系。

